芯片热效应成半导体设计一大挑战 IoT让问题更复杂
发布时间:2016-3-17 11:23
发布者:eechina
|
来源:DIGITIMES 随着汽车、太空、医学与工业等产业开始采用复杂芯片,加上电路板或系统单芯片(SoC)为了符合市场需求而加入更多功能,让芯片热效应已成为半导体与系统设计时的一大问题。 据Semiconductor Engineering报导,DfR Solutions资深工程师指出,随着芯片与电路板越来越小,让热问题显得更加严重。Ansys副总则指出,热会带来一堆无法预知的变化,让业者必须从 芯片封装或系统层次评估热冲击的程度,FinFET制程中必须处理局部过热问题,而且进入10或7纳米后程度更严重。 早在2001年,时任英特尔(Intel)技术长的Pat Gelsinger便曾预测未来10年内,芯片上能源密度提高是必须设法解决的问题。在高密度封装的SoC中,并非所有的废热都能散出。 明导国际(Mentor Graphics)行销经理指出,以车载娱乐系统为例,仪表板会产生热且不易散出,便有可能让绝缘闸极双极性电晶体(IGBT)变得不稳定,因此热管理必须从更接近矽的角度加以评估。 至于预先评估何处以及何时会出现热问题,便必须倚赖各种工具、经验与运气达成。而且随着晶粒上温度不平均,欲计算热对稳定性造成影响为何也越加困难,目前所有EDA厂商已联合企图解决该问题。 Synopsys工程师指出,拥有极准确且资讯充足的模型显得更加重要,但也带给电子设计自动化(EDA)厂商一定压力。益华电脑(Cadence)表示,传统上分析工具大多针对封装温度,但10纳米FinFET后,考量的地方必须从电路板转移至电晶体上。 Sonics技术长也指出,目前漏电流问题依旧存在,而且半导体物理也未改变。外界虽集中在利用时脉来控制功耗,但事实上时脉树(clock tree)仍有许多功耗产生。另一项必须面对的挑战则是动态电源管理。 Wingard 则认为解决之道是提升时脉控制效率,另外,先进封装或是个别晶粒封装等也是可行方式之一。Tessera总裁指出,其牵涉主要问题便是热耗散,也就是晶粒的厚度。因为减少厚度可降低电阻让更多热散出。该公司已开始开发以不同方式堆叠DRAM,让DRAM一部份可以开口让更多冷气进入。 另外,Kilopass等公司也在开发可抗热的一次性可程式(OTP)记忆体,来取代其他种类非挥发记忆体。该公司副总指出,内嵌快闪记忆体可支援到摄氏85度,但OTP可支援到125度。 目前业界也开始研究如何一开始就解决热效应问题。明导国际指出,热矽穿孔(TSV)是研究方向之一,另外,在晶粒下方蚀刻液流道(liquid channels)与引进新的热介面材料也是研究对象。 iROC Technologies总裁指出,高温与高伏特将会提高闩锁效应(latch-up)风险,造成稳定度严重的问题,另一个温度造成的影响则是实际的热中 子(thermal neutron)通量。DfR Solutions认为,热也是造成快闪记忆体逐渐出现位元滑动(bit slip)与资料保存问题的原因。 如今随着物联网(IoT)发展后,上述问题将更加复杂,热问题已逐渐成为设计必考量的一部分,而且与功耗、架构、制程与封装都密切相关。 |


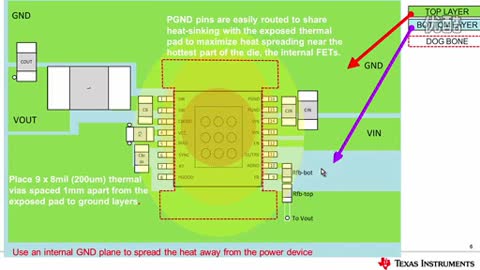
网友评论